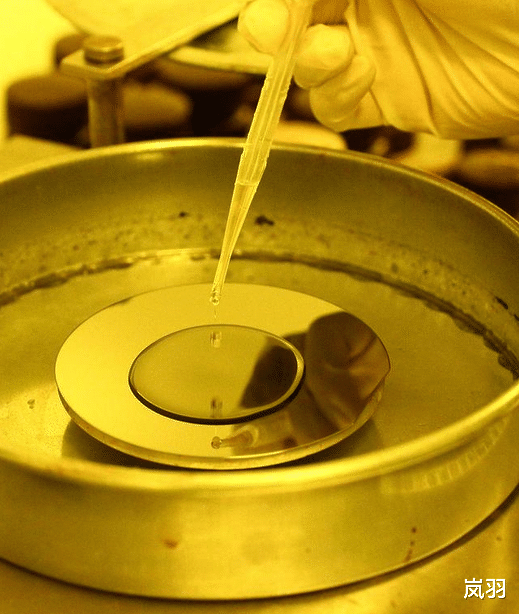
【光刻胶|光刻胶的主要组成成分及其主要技术参数丨半导体行业】光刻胶又称光致抗蚀剂 , 是一种光照后能改变抗蚀能力的高分子化合物 。 一般情况下 , 光刻胶是带有芳香味的具有一定黏度及颜色的液体 。 光刻胶以液态涂覆在硅片表面上 , 曝光后烘烤成固态 。 光刻胶的作用是将光刻板上的图形转移到硅片表面的氧化层中 , 在后续工序中 , 保护下面的材料 。
光刻胶主要由4种成分组成 。
(1)感光剂 。 感光剂是光刻胶的核心部分 , 感光剂经光照后 , 在曝光区能很快地发生光固化反应 , 使得这种材料的物理性能 , 特别是溶解性、亲合性等发生明显变化 。 曝光时间、光源所发射光线的强度都根据感光剂的特性来决定 。
(2)增感剂 。 感光剂的感光速度都较慢 , 生产上效率太低 , 因此向光刻胶中添加了提高感光速度的增感剂 。
(3)溶剂 。 感光剂和增感剂都是固态物质 , 为了方便涂覆 , 要将它们加入溶剂进行溶解 , 形成液态物质 。
(4)添加剂 。 添加剂用以改变光刻胶的某些特性 , 如为改善光刻胶发生反射而添加染色剂等 。
光刻胶的主要技术参数
(1)分辨率 。 分辨率是指区别半导体晶片表面相邻图形特征的能力 。 一般用关键尺寸(Critical Dimension , CD)来衡量分辨率 。 形成的关键尺寸越小 , 光刻胶的分辨率越好 。
(2)对比度 。 对比度是指光刻胶从曝光区到非曝光区过渡的陡度 。 对比度越高 , 形成图形的侧壁越陡峭 , 分辨率越好 。
(3)敏感度 。 敏感度是指光刻胶上产生一个良好的图形所需一定波长光的最小能量值(或最小曝光量) , 单位是毫焦/平方厘米(mJ/cm2) 。 光刻胶的敏感性对于波长更短的深紫外光(DUV)、极深紫外光(EUV)等尤为重要 。
(4)黏度 。 黏度是衡量光刻胶流动特性的参数 。 黏度随光刻胶中溶剂的减少而增加;高黏度会产生厚的光刻胶;黏度越小 , 匀胶后光刻胶的厚度越均匀 。 黏度的单位是泊(poise) , 光刻胶一般用厘泊(cps , 厘泊为1%泊)来度量 。
(5)黏附性 。 黏附性表征光刻胶黏着于衬底的强度 。 光刻胶的黏附性不足会导致半导体晶圆片表面的图形变形 。 光刻胶的黏附性必须经受住后续工艺 , 比如刻蚀、离子注入和热扩散等 。
(6)抗蚀性 。 光刻胶必须有较强的抗蚀性 , 才能在后续的工序中起到保护作用 。
(7)表面张力 。 表面张力是指液体中将表面分子拉向液体主体内的分子间吸引力 。 光刻胶的表面张力越大 , 它的覆盖性就越差 。 光刻胶应该具有比较小的表面张力 , 使光刻胶具有良好的流动性和覆盖能力 。
(8)曝光速度 。 曝光速度越快 , 在光刻蚀区域晶圆的加工速度就越大 , 负光刻胶通常需5~15s时间曝光 , 正光刻胶较慢 , 其曝光时间为负胶的3~4倍 。
(9)针孔密度 。 针孔是光刻胶层尺寸非常小的空穴 。 针孔是有害的 , 因为它可以允许刻蚀剂渗过光刻胶层进而在晶圆表面层刻蚀出小孔 。 针孔是在涂胶工艺中由环境中的微粒污染物造成的 , 或者由光刻胶层结构上的空穴造成的 。 光刻胶层越厚 , 针孔越少 , 但它也降低了分辨率 , 光刻胶厚度的选择过程中需权衡这两个因素的影响 。 正胶的纵横比较高 , 所以正胶可以用更厚的光刻胶膜达到想要的图形尺寸 , 而且针孔密度更低 。
(10)阶梯覆盖度 。 晶圆在进行光刻工艺之前 , 表面已经有了很多的层 。 光刻胶要能起到阻隔刻蚀的作用 , 必须在以前层的上面保持足够的膜厚 。 光刻胶用足够厚的膜来覆盖晶圆表面层的能力即阶梯覆盖度 , 它是一个非常重要的参数 。
相关经验推荐
- iPhoneSE|iPhone SE3的5种网传渲染图曝光,你最相信哪一个?
- 高通骁龙|从3699跌至1899,价格腰斩后的老旗舰,比千元机强大很多
- 海信|销量最好的85英寸海信Vidda85V1F-S突然在热销榜中消失,原因简单
- 绘画|三千左右性价比最高的双电机电动升降桌—极创悠品电脑升降桌
- ColorOS|手机上的私人助理?ColorOS 12负一屏体验:好玩又高效
- 小米科技|2022拍照最好的几款手机,堪比小单反,经常拍照的可以考虑一下
- 广角镜头|iPhone 13 Pro Max 测评:给一个优质的五星好评!
- Google|谷歌推出首批适用于Windows系统的Android游戏
- iPhone|聊一聊iphone一直闭口不谈的弊端!
- 华为鸿蒙系统|蒙系统的那些卡片功能,也就是刚面世时候的噱头,用下来用处不大










