
文章图片
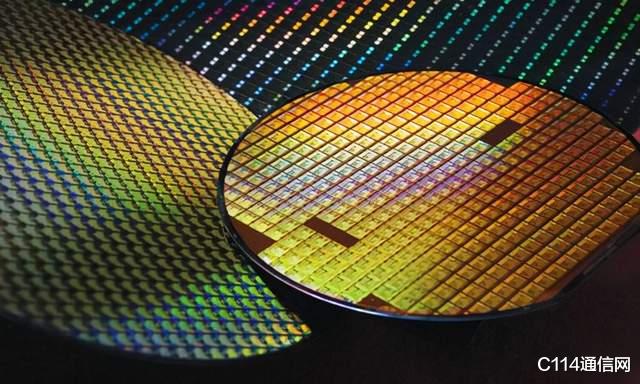
文章图片
据日经新闻报道 , 英特尔、台积电和三星将携手共同打造一个先进芯片封装技术的行业标准 , 这是打造更强大电子设备的下一个关键战场 。
【网约车|英特尔台积电三星组建联盟,将合作开发芯片封装和堆叠技术】全球三大芯片制造商与其他几家领先科技公司本周四宣布 , 他们将组建一个联盟 , 在下一代芯片封装和堆叠技术方面展开合作 , 这是半导体制造中芯片安装到印刷电路板上并组装进电子设备之前的最后一步 。
世界领先芯片厂商之间的罕见合作突显出业界目前对这些技术的重视程度 。 全球顶级芯片开发商和科技巨头——从AMD、高通和Arm , 到Google Cloud、Meta和微软——也将加入该联盟 , 全球最大的芯片封装和测试服务供应商日月光科技控股公司也将加入该联盟 。
该联盟表示对更多公司加入其中持开放态度 。
以前 , 芯片封装被认为没有芯片制造本身那么重要 , 技术要求也不高 。 但随着三星、英特尔和台积电等全球顶级芯片制造商寻求生产更强大的芯片 , 该领域已成为它们的主要战场 。
到目前为止 , 半导体的发展主要集中在如何将更多的晶体管压缩到芯片上——一般来说 , 更多的晶体管意味着更强的计算能力 。 但随着晶体管之间的距离缩小到只有几个纳米 , 这种方法变得更具挑战性 , 导致一些人预测摩尔定律即将终结 , 摩尔定律假设芯片上的晶体管数量每两年翻一番 。 因此 , 如何将不同功能和特性的微型芯片以最有效的方式封装和堆叠在一起 , 已成为大多数芯片制造商热衷攻破的关键领域 。
这一新联盟的目标是建立一个被称为Universal Chiplet Interconnect Express(UCIe)的单芯片封装标准 , 以创建一个新的生态系统 , 并促进封装和堆叠技术领域的合作 。 将不同类型的芯片(或所谓的小芯片)更好地组合在一个封装中 , 可以创造出更强大的芯片系统 。
UCIe将提供一个完整的\"die-to-die\"互连标准 , 使最终用户能够轻松地混合和匹配小芯片组件 。 这意味着他们将能够使用来自不同供应商的部件来构建定制的片上系统(SoC) 。 一个单独的芯片在被封装之前被称为die 。
参与该联盟的谷歌和AMD都是首批采用台积电最先进的3D芯片堆叠技术的公司 。
尚未加入该联盟的苹果公司 , 是首家使用台积电在2016年自研的首批芯片封装技术的公司 , 并继续在其最新款iPhone处理中使用了这些技术 。
报道称 , 尚未加入该联盟的中国科技巨头华为也在努力自研尖端芯片堆叠和封装技术 。 (C114 艾斯)
相关经验推荐
- 台积电|台积电做出芯片新决定,苹果和ASML要坐不住了
- 京东|英特尔和AMD垄断了电脑CPU,为何不去垄断手机CPU?
- 酷睿处理器|英特尔开启疯狂模式,12代酷睿提升巨大,笔记本购买建议分享
- 芯片|英特尔、高通、三星、ARM们组小芯片联盟,不带中国厂商玩?
- MySQL|假如台积电一意孤行,偷偷给华为代工芯片,会有怎样的后果?
- 英特尔|纷纷响应制裁俄罗斯:台积电、英特尔、AMD等皆已断供
- 小米科技|重回1999元!曲面屏+3200万前置+台积电6nm,女神节礼物绝佳选择
- 英特尔|强强联合!OPPO Find X5携手马龙将擦出怎样的火花?
- 机器人|说人话系列:英特尔酷睿12代详解(1)从酷睿i初代开始
- 台积电|丢掉高通订单,良品率低到难以置信,三星超车台积电机会大吗?


















